우리 서비스가 필요한 이유는 프로젝트가 제대로 수행되고 기능하는지 확인할 수 있는 전문 지식과 경험을 갖춘 고도로 자격을 갖춘 전문가를 확보하고 있다는 것입니다.
완벽하게 밀봉된 전자 패키지는 수십 년 동안 중단, 오류 또는 성능의 현저한 저하 없이 의도된 기능을 수행할 수 있습니다. 그러나 설계 및 현장 엔지니어는 차세대 반도체 기반 전자 패키지를 제작하기 위해 적합한 재료와 밀봉제를 적용하고, 올바른 도구, 장비 및 공정 단계를 사용해야만 이러한 수준의 성능을 달성할 수 있습니다. 잘 밀봉된 패키지에서 비롯되는 자신감은 필연적으로 더 많은 기능을 갖춘 더 나은 칩 개발로 이어집니다.
MATERION CORPORATION 마이크로일렉트로닉 패키징 기술 이사, 라메쉬 코탄다파니
밀폐 밀봉은 반도체 칩 패키징에 중요한 공정입니다. 이 경우 "밀폐"라는 단어는 누출 방지 밀봉을 의미합니다. 반도체 칩은 웨이퍼에서 시작하여 개별 칩으로 절단되고, 최종적으로 개별 패키지로 완성되는 여러 공정 단계를 거칩니다. 이러한 칩은 다이 부착 에폭시 또는 공융 솔더를 사용하여 다이 패드에 단단히 접합됩니다. 그런 다음 매우 가는 와이어를 사용하여 세라믹 패키지 본드 패드에 전기적으로 연결됩니다.
세라믹 패키지(실제로는 "칩 캐리어"라고 함)는 일반적으로 세라믹 본체 내부에 전기 피드스루가 있는 다층 구조입니다. 이러한 층들은 패키지의 바닥이나 측면에 내부적으로 연결되어 다른 전기 부품과 함께 인쇄 회로 기판에 장착됩니다. 칩 본딩에는 리드형 칩 캐리어(LCC), 세라믹, 쿼드, 플랫팩(CQFP), 쿼드 플랫 패키지(QFP) 등 다양한 패키지가 제공됩니다.
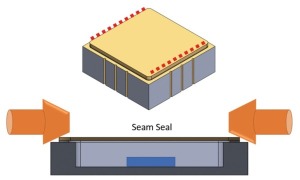
세라믹 패키지는 뚜껑을 녹여 세라믹이나 금속 패키지에 밀봉하기 위해 평행하게 두 개의 전극이 달린 솔기 밀봉 방식입니다.
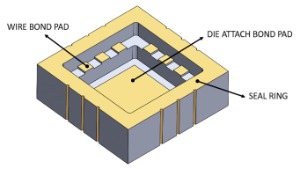
씰 링과 와이어 및 다이 본드 패드가 포함된 세라믹 패키지입니다.
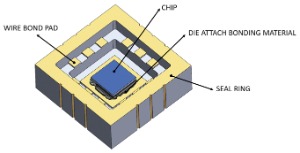
칩이 부착된 세라믹 패키지.
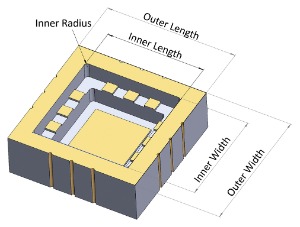
씰 링 치수가 있는 세라믹 패키지.
와이어 본드가 있는 칩이 들어 있는 세라믹 패키지는 습기나 느슨한 입자와 같은 오염 물질의 유입을 막기 위해 결국 밀폐되어야 합니다.
밀폐 밀봉 공정은 어셈블리의 작동 가능성을 판단하는 데 매우 중요합니다. 그림 1은 반도체 칩과 수백 개의 매우 미세한 와이어 본드를 보여줍니다. 이 칩들은 크기가 수 밀리미터에서 수십 밀리미터에 이릅니다. 칩이 작을수록 와이어 본드 개수가 적고, 칩이 클수록 수백 개의 와이어 본드가 있을 수 있습니다. 이러한 와이어 본드는 머리카락보다 얇으며, 지름은 0.0007인치(17.78마이크론)에 불과합니다.
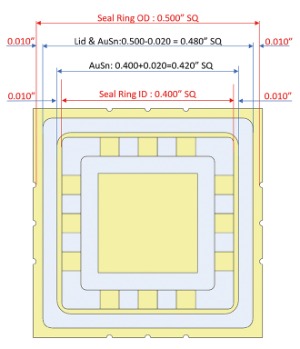
패키지 뚜껑과 납땜에 대한 설계 지침.

그림 7. 금-주석 상태도.
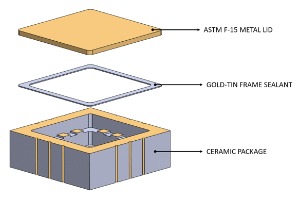
세라믹 패키지, 솔더 프레임 및 도금된 금속 뚜껑의 분해도입니다.
개별 칩에는 육안으로는 볼 수 없는 초미세 기어, 시계, 그리고 움직이는 액추에이터가 장착된 미세 전기 기계 시스템(MEMS)이 내장되어 있습니다. 이러한 칩에 쌓인 입자는 칩의 성능을 저해할 가능성이 높습니다. 또한, 접합된 미세 와이어가 서로 너무 가까이 있기 때문에 와이어 사이의 전도성 입자나 습기가 오작동을 유발할 수 있습니다. 따라서 조립된 패키지의 적절한 밀봉이 더욱 중요합니다.
밀봉 과정에 집중하기 전에 밀봉에 사용되는 재료, 한계, 설계 지침, 보관 및 취급 과정에 대해 아는 것이 중요합니다.
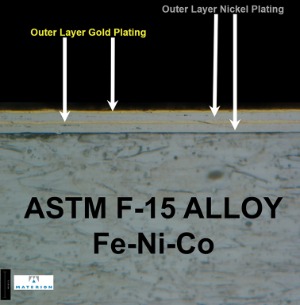
니켈과 금을 순차적으로 도금한 4개 층의 단면도입니다.
예를 들어, 세라믹 패키지에는 여러 유형이 있습니다.
• 표면 실장 세라믹 패키지
• 세라믹 핀 그리드 어레이 패키지
• 세라믹 쿼드 플랫 패키지
• 세라믹 하이브리드 패키지
• 광섬유 통신 패키지
• 접합 재료 또는 솔더
• 패키지에 부착해야 하는 구성 요소(예: 다이, 다이 부착 재료, 와이어 등)
필요한 밀폐성 수준에 따라 패키지는 1개 또는 2개의 밀봉 공정을 거칩니다. 금속 뚜껑으로 이음매 밀봉하거나 도금된 금속 뚜껑으로 납땜 밀봉합니다.
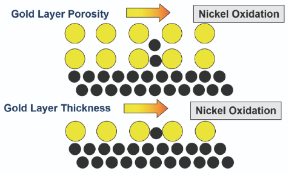
니켈 마이그레이션 과정.
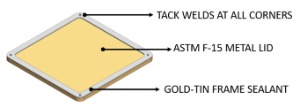
프레임 뚜껑 조립.
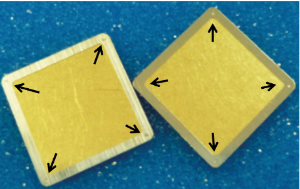
모서리에 점용접 지점을 만듭니다.
금속 뚜껑으로 밀봉됨:
이는 한 쌍의 둥근 전극이 뚜껑 가장자리를 따라 움직이면서 녹아내리고 패키지의 씰 링 부분에 융합되는 안정적인 밀폐 밀봉 공정입니다. 심 실링은 다음과 같은 경우에 유용합니다.
• 반도체 칩은 높은 열을 견딜 수 없습니다. 심 실링은 가장자리에 국부적인 가열을 제공합니다.
• 사용자에게 오븐 리플로우 기능이 없을 수 있습니다.
• 최종 응용 분야는 낮은 수준의 밀폐성이 요구되는 RF 관련입니다(예: RF 패키징).
도금된 금속 뚜껑이 있는 납땜 밀봉:
이 공정은 높은 수준의 신뢰성 있는 기밀 밀봉을 달성할 수 있습니다. 밀봉 후 여러 가지 테스트를 통해 그 효과를 확인할 수 있습니다.
다이 본드 패드, 와이어 본드 패드, 씰 링 등의 사용을 포함하여 모든 패키지 유형에 공통적인 몇 가지 요소가 있습니다. 그림 3은 세라믹 패키지의 몇 가지 주요 특징을 보여줍니다.
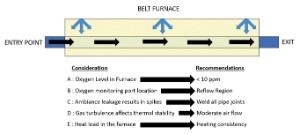
그림 13. 벨트로를 사용한 효과적인 밀폐를 위한 중요한 매개변수 제어 및 권장 사항.
다이 어태치 패드: 공융 솔더 합금이나 에폭시 재료를 사용하여 반도체 칩을 부착하는 부분입니다. 에폭시 기반 다이 어태치 접착제는 일반적으로 수지와 경화제로 구성되며, 다이 패드에 도포하기 전에 잘 혼합해야 합니다. 그런 다음 칩을 제자리에 놓고 압력을 가하여 문질러 젖음을 시작하고 접착 재료에 갇힌 가스를 방출합니다. 어셈블리는 고온에서 경화되는데, 이는 매우 까다로울 수 있으므로 적절한 제어가 필요합니다.
88Au12Ge와 80Au20Sn 모두 공융 접합 재료로 사용할 수 있습니다. 두 재료는 각각 361°C와 280°C에서 녹습니다. 픽스처 및 기타 부품으로의 열 손실을 고려하면 설정 온도는 일반적으로 더 높습니다. 두 가지 유형의 공융 솔더는 모두 바인더나 접착제가 없는 순수 합금입니다.
다이 접착 본딩 재료의 선택은 칩 및 본딩제가 접촉할 수 있는 주변 재료의 열팽창계수(CTE)에 따라 달라집니다. 용융 및 경화 온도와 조건 또한 결정되어야 합니다.

진공로 내부 챔버.
칩 부착 후 밀봉 조건:
안전한 접합을 검증하고 갇힌 가스가 방출되도록 하는 것이 중요합니다. 공급업체는 일반적으로 유기물과 바인더를 제거하기 위한 경화 지침과 공정 단계를 제공합니다. 그렇지 않으면 솔더 밀봉 공정 중에 수소 포화 탄화수소나 습기가 방출될 수 있습니다. 패키지 내부에 갇힌 가스는 전반적인 전기적 성능과 수명에 부정적인 영향을 미칩니다.
따라서, 보이드 없는 접합을 위해서는 다이 접착 공정을 효과적으로 제어하는 것이 중요합니다. 하지만, 사후 검증은 비용이 많이 들고 불규칙하거나 잘못된 결과를 초래할 수 있습니다. 따라서 보관 조건, 유효기간, 혼합 비율, 사용 기간, 그리고 교대 근무 시 필요한 단위 용량에 세심한 주의를 기울여야 합니다. 또한, 주변 환경에서 수분이 흡수될 가능성도 있습니다.

금-주석 리플로우 프로파일.
씰 링:
이는 세라믹 패키지의 기밀 밀봉에 있어 가장 중요한 부품 중 하나입니다. 다이 및 와이어 본드 패드와 마찬가지로, 씰 링의 거의 전체 표면이 납땜 공정에 사용됩니다. 씰 링 표면은 일반적으로 다공성이며 니켈과 금으로 도금되어 있어 고온에서 니켈이 씰 링으로 이동할 수 있습니다. 이로 인해 핀홀과 솔더 보이드가 발생할 수 있습니다. 따라서 신중한 취급과 온도 관리가 필수적입니다.
효과적인 밀폐 밀봉: 단계별 설명
성공적인 밀폐는 다음을 포함한 여러 요인에 달려 있습니다.
• 패키지 씰 링에 대한 설계 지침
• 실란트 및 뚜껑 재질 선택
• 밀봉 방법 및 공정 제어
• 밀폐 후 밀봉 테스트 및 문제 해결
• 차세대 포장재 옵션
패키지 씰 링의 설계 지침:
밀폐형 덮개 뚜껑과 납땜의 크기를 고려하십시오. 외부 씰 링, 금속 뚜껑, 그리고 금-주석 프레임은 핵심 디자인 요소입니다. 예를 들어, 패키지 씰 링의 외부 길이와 너비가 0.500인치 정사각형이라면, 뚜껑은 0.500인치 - 0.010인치 - 0.010인치, 즉 0.480인치 정사각형이어야 합니다.
다음으로 금-주석 솔더 내부 치수를 결정해야 합니다. 이를 위해서는 내부 및 외부 치수를 모두 고려해야 합니다. 씰 링 내부 치수가 0.400인치 정사각형이면, 금-주석 솔더 내부 치수는 0.400인치 + 0.010인치 + 0.010인치, 즉 0.420인치 정사각형이어야 합니다. 내부 및 외부 반경은 솔더와 뚜껑의 두께와 마찬가지로 전체 설계에 중요합니다. 이러한 치수는 최종 패키지의 크기에 따라 결정됩니다. 0.010인치 간격은 씰 링의 공간 여유 여부에 따라 달라집니다. 외부 간격은 0.002인치까지, 링이 좁은 경우 내부 씰 링의 간격도 거의 0.002인치만큼 낮아질 수 있습니다.
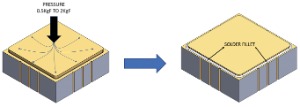
그림 16: 왼쪽, 압력을 가한 조립 상태. 오른쪽, 솔더 필렛을 사용한 후 밀봉 상태.
실란트 재료 선택:
누출 방지 밀폐 접합에 적합한 다양한 솔더 합금과 공융 솔더가 있습니다. 금-주석 솔더는 금속 뚜껑을 세라믹 또는 금속 패키지에 접합하는 데 특히 효과적인 것으로 입증되었습니다. 80% 금/20% 주석 솔더는 280°C에서 녹으며, 온도 사이클 테스트에서도 우수한 내구성을 보입니다.
80% 금/20% 주석 합금은 불순물이 거의 없이 제조되어야 하며, 양호한 결합을 달성하기 위해 명목 중량 백분율 내에 있어야 합니다.
• 금-주석 순도: 열전도도 감소
• 금-주석 오염: 산화물, 유기물
• 금-주석 계면 접촉 영역

다양한 신뢰성 테스트.
뚜껑 재질 선택:
금속 뚜껑은 ASTM F-15 규격에 따라 철, 니켈, 코발트의 합금으로 제작됩니다. 금-주석 땜납이 패키지와 잘 접합되도록 금속 뚜껑을 잘 준비해야 합니다. 철(Fe) 성분이 50% 이상인 뚜껑은 시간이 지남에 따라 산화될 수 있습니다. 맨 뚜껑은 금-주석 땜납이 젖는 것을 허용하지 않습니다. 따라서 안정적인 금 도금이 필수적입니다.
뚜껑은 100~350마이크로인치 두께의 니켈로 전기 도금되고, 그 후 50마이크로인치 두께의 금이 도금됩니다. 고신뢰성 애플리케이션을 위해 니켈과 금이 추가로 도금되지만, 두 니켈 피막의 합은 450마이크로인치를 초과할 수 없고, 금도금 피막의 합은 최소 50마이크로인치 이상이어야 합니다. 이는 가장자리에 과도한 도금층이 쌓이는 것을 방지하기 위한 것으로, 밀봉에 부정적인 영향을 미칠 수 있습니다. 다음 그림은 4겹 도금된 뚜껑의 단면도입니다.
효과적인 도금:
도금 공정은 매우 중요합니다. 예를 들어, 엣지 빌드업(Edge build-up)은 반드시 피해야 합니다. 전기 도금조와 화학 물질 관리는 모두 중요합니다. 이 도금은 외관상의 목적이 아니라 고품질의 기밀 밀봉을 위해 설계되었으며, 이는 우수한 솔더 본딩을 수반합니다. 관리가 부족한 도금은 원치 않는 가스를 가두어 둘 수 있습니다.
도금 후 테스트는 도금 품질을 점검하는 데 사용할 수 있으며, 특히 도금된 필름의 수소 함량을 정량화하는 데 사용할 수 있습니다.
도금조 유지관리 및 도금조 화학 검사는 예방적 목적으로 주기적으로 수행해야 합니다. 도금 후 베이크아웃은 최종 단계 도금 후 120°C~150°C의 낮은 온도에서 8~12시간 동안 수행되는 경우도 있습니다.
고온 베이크아웃을 장시간 진행하면 니켈 내부층이 금층으로 이동하여 솔더 젖음성을 저해할 수 있습니다. 금-주석 솔더 합금은 니켈에 젖지 않습니다. 도금층이 너무 얇거나 도금 표면에 기공이 많은 경우에도 니켈 이동이 발생할 수 있습니다.
밀봉 방법 및 공정 제어
• 택 용접 또는 점 용접: 금-주석 땜납은 도금된 뚜껑에 점 용접 또는 택 용접으로 부착해야 합니다. 이 공정은 씰 수율에 영향을 미칠 수 있는 정렬 불량 및 기타 결함을 방지하는 데 매우 중요합니다. 또한 최종 밀봉 전에 프레임과 뚜껑을 단일 부품으로 조립해야 하는 최종 사용자에게 추가적인 이점을 제공합니다. 택 용접은 네 모서리 모두에서 공정 금-주석 땜납의 매우 작은 부분만 녹여 도금된 뚜껑에 부착하면 됩니다.
• 리플로우 장비 및 공정 제어: 밀봉 전에 적절한 리플로우 장비를 선택하는 것이 중요합니다. 금-주석 또는 기타 솔더를 사용한 기밀 밀봉에는 불활성 환경이 필요합니다. 그렇지 않으면 산화가 밀봉의 무결성에 영향을 미칠 수 있습니다. 벨트 퍼니스를 사용하는 경우, 유지보수 및 밀봉 프로파일을 면밀히 모니터링해야 합니다. 리플로우 챔버 내의 산소 함량을 추적하고 관리해야 합니다. 진공 밀봉 퍼니스를 선택하는 경우에도 유사한 모니터링이 필요하며, 불필요한 가스를 제거하는 추가적인 이점이 있습니다. 두 경우 모두 장비 성능이 기밀 밀봉의 품질을 결정합니다.
금-주석 밀봉 프로필: 금-주석 밀봉 프로필에 대한 주요 고려 사항은 다음과 같습니다.
• 상승 속도: 상승 속도는 점진적이고 느려야 합니다. 이는 니켈 이동을 촉진하지 않으면서 다양한 부품에서 가스를 방출하는 데 도움이 됩니다. 이러한 이동은 특히 다공성 도금층의 경우, 램프업 속도가 빨라질수록 발생할 수 있습니다. 진공로는 모든 가스를 배출하며, 질소 압력이 있는 벨트로는 동일한 효과를 발휘합니다.
• 최고 온도: 공융 금-주석 솔더의 용융 온도는 280°C입니다. 밀봉 부품 외에도 고정 장치, 클립 및 기타 재료도 열을 흡수할 수 있습니다. 솔더와 뚜껑이 최고 온도에 도달하면 목표를 달성해야 합니다.
가스의 완전한 제거, 솔더의 완전한 유동, 솔더 필렛 형성, 그리고 핀홀이나 보이드 제거를 의미합니다. 최고 온도 노출 시간은 매우 주관적이며 제품 크기, 조립 도구 및 조건에 따라 달라집니다. 중요 공정이 진행되는 동안 이 시간을 줄이면 육안, 누출 테스트 또는 X선 촬영을 통해 관찰할 수 있는 고장 모드를 발견할 수 있습니다.
• 피크 구역에서의 냉각 감소: 제품 냉각도 점진적으로 이루어져야 합니다. 제품을 오븐에서 갑자기 냉각하거나 꺼내는 것은 매우 위험할 수 있습니다.
• 양호한 기밀 접합을 위해서는 금-주석 땜납에 적절한 압력을 가해야 합니다. 하지만 흥미롭게도 약 0.5~4kg의 힘만 필요합니다. 모든 경우에서 압력은 뚜껑에서 금-주석 실란트로 전달됩니다(그림 16 참조). 앞서 언급했듯이, 이 압력은 최고 온도 단계에서 뚜껑을 누르고 용융 땜납을 압착하여 필렛을 형성하는 데 매우 유용합니다.
씰 클립:
쉽게 구할 수 있는 다양한 종류의 클립이 있습니다. 패키지 종류와 생산량에 따라 압력 클립을 맞춤 제작할 수 있습니다. 생산량 증가가 필요한 경우 정렬 고정 장치도 고려해야 합니다.
밀봉 후 신뢰성 테스트:
밀봉 후 신뢰성 시험은 공정 및 재료 선정의 유효성을 검증합니다. 여러 단계의 시험이 순차적으로 수행됩니다. 나열된 모든 시험의 세부 정보는 표준 Mil-883 가이드북에서 확인할 수 있습니다.
차세대 포장재 옵션: 이 테스트는 성공적인 밀봉을 확인하기 위한 것입니다. 마찬가지로, 효과적인 포장 공정은 현장에서 패키지의 수명을 크게 연장할 수 있습니다. 위성이나 우주선에 설치된 보드 레벨 모듈과 같은 많은 응용 분야는 교체나 수리가 불가능합니다. 따라서 이러한 모듈은 가장 열악한 조건에서도 내구성을 유지하도록 제작됩니다.
다양한 신소재와 공정이 시장에 출시되고 있습니다. 예를 들어 차세대 기밀 밀봉 애플리케이션을 위해 다양한 혁신적인 커버 뚜껑이 출시되었습니다. 여기에는 광통신용 기밀 커버 또는 Visi-Lid, 전자기식 노즈 컨트롤용 비자성 콤보 뚜껑, 그리고 패키지에서 수소 방출을 억제하는 게터 콤보 뚜껑이 포함됩니다.
본 기사는 원래 Power Electronics World 2024년 1호에 게재되었습니다.
우리 서비스가 필요한 이유는 프로젝트가 제대로 수행되고 기능하는지 확인할 수 있는 전문 지식과 경험을 갖춘 고도로 자격을 갖춘 전문가를 확보하고 있다는 것입니다.
무료 상담을 원하시면 양식을 작성하여 bg를 시작하십시오.:
받은 편지함에서 판매 정보, 뉴스 및 업데이트를 수신합니다.
 闽ICP备19012761号-1
闽ICP备19012761号-1



